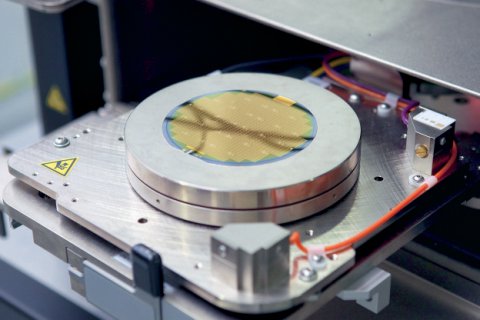 Холдинг “Росэлектроника” Госкорпорации Ростех приступил к выпуску нитрид-галлиевых (GaN) транзисторов для создания сетей связи 5G и нового поколения систем радиолокации. Опытные образцы СВЧ-приборов прошли испытания в составе аппаратуры квадрокоптеров, радиостанций и аппаратуры локации аэропортов и в настоящее время поставляются более 20 предприятиям для тестовой эксплуатации. Транзисторы ПП9137А обладают высоким значением удельной выходной мощности, широкой полосой согласования, высоким значением пробивных напряжений “сток-исток”. Выходная мощность приборов – от 5 до 50 Вт, коэффициент усиления по мощности – от 9 до 13 дБ, КПД стока – не менее 45% на тестовой частоте 4 ГГц и 2,9 ГГц.
Холдинг “Росэлектроника” Госкорпорации Ростех приступил к выпуску нитрид-галлиевых (GaN) транзисторов для создания сетей связи 5G и нового поколения систем радиолокации. Опытные образцы СВЧ-приборов прошли испытания в составе аппаратуры квадрокоптеров, радиостанций и аппаратуры локации аэропортов и в настоящее время поставляются более 20 предприятиям для тестовой эксплуатации. Транзисторы ПП9137А обладают высоким значением удельной выходной мощности, широкой полосой согласования, высоким значением пробивных напряжений “сток-исток”. Выходная мощность приборов – от 5 до 50 Вт, коэффициент усиления по мощности – от 9 до 13 дБ, КПД стока – не менее 45% на тестовой частоте 4 ГГц и 2,9 ГГц.
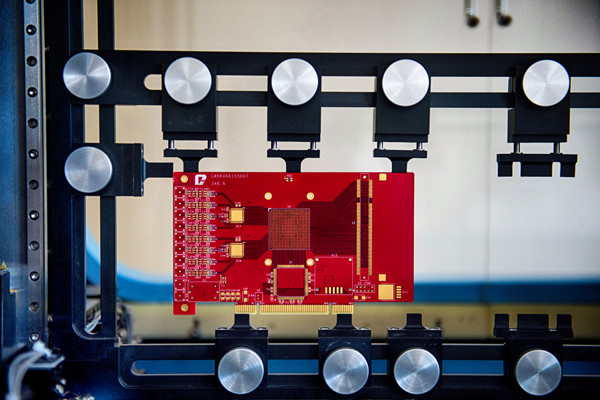
Транзисторы полностью взаимозаменяемы с импортными аналогами, что позволяет не проводить дополнительных настроек в составе аппаратуры. Разработчиком изделий выступило воронежское АО “НИИ электронной техники” (в составе холдинга входит в Концерн “Созвездие”). Предприятие в настоящее время работает над расширением линейки GaN-транзисторов. Гетероэпитаксиальные структуры GaN и твердых растворов на его основе находят все более широкое применение в области радио- и силовой электроники.
Развитие производства мощных переключательных транзисторов, созданных на основе GaN, как ожидается, приведет к значительному уменьшению габаритов блоков питания, адаптеров, зарядных устройств. В частности, позволит принципиально сократить массу и повысить эффективность электромобилей и гибридов. СВЧ/GaN-транзисторы в сетях связи позволят увеличить объемы передаваемого трафика за счет большего диапазона частот.
Как сообщалось, специалисты московского предприятия Росэлектроники – АО “ГЗ “Пульсар” совместно с совместно с Институтом сверхчастотной полупроводниковой электроники РАН (Москва) ранее провели работы по созданию приемопередающих модулей на основе GaN в диапазонах 23-25 ГГц и 57-64 ГГц.

Справка:
Применение нитрида галлия (GaN) в качестве материала для производства транзисторов началось относительно недавно. Первые демонстрации эффективных транзисторных гетероструктур AlGaN/GaN, выявляющие их основные преимущества и перспективы, относятся к началу 1990-х годов. В конце 1990-х годов появляются первые образцы компонентов, одновременно формируются и начинают выполняться военные и государственные программы развития данного направления.
В то же время практически все ведущие мировые электронные компании, так или иначе связанные с производством GaAs и Si компонентов, начинают собственные инвестиции в технологию GaN приборов. Эти инвестиции приносят свои плоды, и в 2006-2007 годах анонсируются, а затем и появляются на рынке реальные коммерческие GaN-продукты: корпусированные мощные транзисторы в диапазоне частот от 2 до 4 ГГц с выходной мощностью от 5 до 50 Вт (несколько позднее и до 120-180 Вт). Пионерами выхода на коммерческий рынок стали компании Eudyna, Nitronex, Сree и RFHIC, чуть позднее к ним присоединятся Toshiba, RFMD, TriQuint, OKI, NXP и ряд других компаний [1].
Преимущества использования GaN технологии изготовления транзисторов.
Учитывая современные требования, в последние годы заметно активизировались исследования широкозонных полупроводников (карбида кремния, нитрида галлия, нитрида алюминия и др.) и приборов на их основе. Уникальные свойства этих полупроводниковых материалов (большая ширина запрещенной зоны, высокие значения подвижности носителей заряда и их скоростей насыщения, большие коэффициенты теплопроводности и т.д.) обеспечивают создание на их основе приборов с рекордными значениями мощности, напряжения и тока.
Интенсивные исследования в области разработок полевых транзисторов на основе GaN, активно поддерживаемые военными, позволили создать промышленные образцы приборов с рекордными значениями мощности, которые предполагается использовать в современных системах связи, оборонных и космических применениях.
Наиболее перспективным широкозонным материалом в настоящее время является нитрид галлия, имеющий ширину запрещенной зоны около 3,5 эВ, подвижность и скорость насыщения электронов – около 2000 см2/В*с и 2,7*107 см/с, теплопроводность – более 1,5 Вт/м*К [2]. Отметим далее физические свойства широкозонных полупроводниковых соединений в общем, и GaN в частности, позволяющие добиться реального улучшения характеристик приборов по сравнению с традиционными кремнием и арсенидом галлия (таблица 1).
| Характеристики материала | Si | GaAs | SiC | GaN |
| Ширина запрещённой зоны, эВ | 1,1 | 1,4 | 3,2 | 3,5 |
| Критическая напряженность электрического поля, *106 В/см | 0,3 | 0,4 | 3 | 3,3 |
| Теплопроводность, Вт/м*K | 1,5 | 0,5 | 4,9 | >1,5 |
| Подвижность электронов, см2/В*с | 1350 | 8500 | 700 | 2000 |
| Дрейфовая скорость насыщения электронов, *107 см/с | 1,0 | 2,0 | 2,0 | 2,7 |
Таблица 1. Сравнение свойств полупроводниковых материалов
Максимальная ширина запрещенной зоны (в 3 раза больше, чем у кремниевой технологии) обуславливает возможность работы транзистора при высоких уровнях температуры и радиации. Теоретически, транзисторы на основе GaN с шириной запрещенной зоны 3,5 эВ должны сохранять работоспособность при температурах до 500°С. На практике же в настоящее время максимальная температура стабильной работы транзисторов, изготовленных на подложках из карбида кремния, составляет более 200°С.

Фирма Nitronex, приложившая огромные усилия по коммерциализации GaN транзисторов на более дешевых, но менее теплопроводных кремниевых подложках (по сравнению с SiC), провела серию испытаний этих приборов на надежность при рабочей температуре 200°С. Испытания 45 приборов компании (ширина затвора Wз = 16 мм, Vси раб. = 28 В) в течение 1500 ч при температуре 200°С показали, что они могут работать с обычным воздушным охлаждением. По мере совершенствования качества эпитаксиальных структур и технологии производства рабочая температура GaN транзисторов должна быть увеличена до 350–400°С [3].
Рекордная удельная плотность мощности – одно из самых выдающихся достижений в области создания ВЧ GaN компонентов нового поколения. Максимальная критическая напряженность электрического поля (в 10 раз большая, чем у кремния) позволяет реализовать пробивные напряжения в 100-300 В и поднять рабочее напряжение стока до 50-100 В, что в сочетании с высокой плотностью тока обеспечивает удельную выходную мощность промышленных GaN-транзисторов 3-10 Вт на 1 миллиметр ширины затвора (до 30 Вт/мм в лабораторных образцах), что на порядок превышает удельную выходную мощность GaAs транзисторов. Высокое напряжение питания стока приводит к увеличению на порядок импеданса нагрузки стока и значительному облегчению согласования транзистора с нагрузкой.
За счет существенно большей теплопроводности как эпитаксиальных пленок, так и подложки-носителя, а также за счет втрое большей ширины запрещенной зоны в транзисторах на основе нитрида галлия достигаются большие значения мощности от одного компонента, при этом уменьшаются размеры конечных изделий и устраняется необходимость применения систем охлаждения.
Сочетание высокой концентрации электронов проводимости, высокой подвижности электронов и большей ширины запрещенной зоны дает возможность GaN-транзисторам достичь существенного снижения значения сопротивления канала во включенном состоянии. По сравнению с кремниевыми приборами в силовых транзисторах на основе GaN может быть достигнуто снижение значения RDS(on) более чем на порядок в диапазоне напряжений пробоя от 100 до 300 В. Это позволит GaN-транзисторам заменить Si и даже SiC транзисторы в силовых системах, где требуются приборы с высокими значениями рабочих токов и напряжениями 1000 В и выше. Применение GaN-транзисторов позволит снизить потребление энергии в системах запуска электродвигателей, защиты электросетей от перегрузок и неожиданных отключений. Кроме того, очень высокая концентрация электронов в области двумерного электронного газа в сочетании с приемлемой подвижностью электронов дает возможность реализации большой плотности тока транзистора и высокого коэффициента усиления.
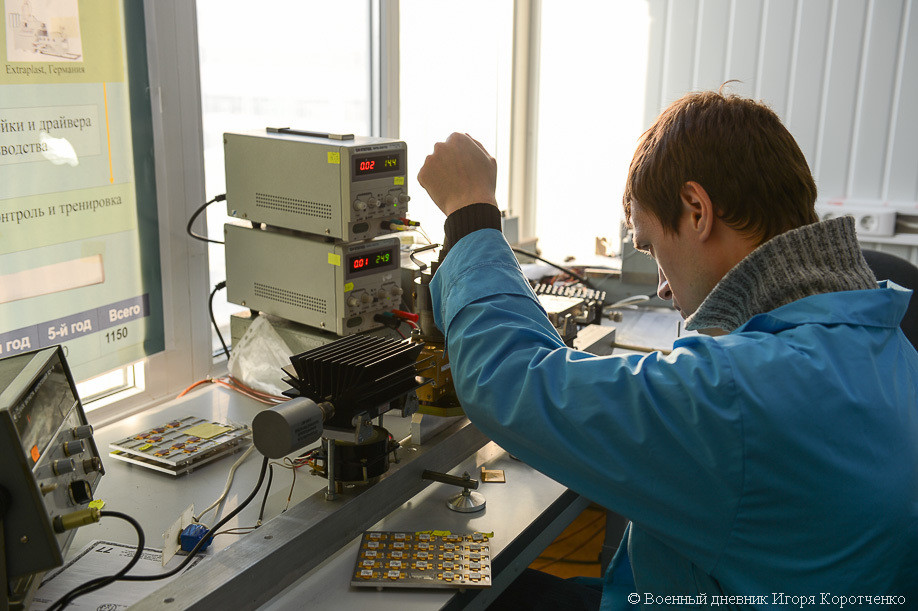
Приведенные параметры приборов на GaN хотя и значительны, но не предельны. Это обусловлено как недостатками материалов подложки, так и несовершенством выращиваемых на них эпитаксиальных структур. Подложки для GaN должны иметь минимальное расхождение с нитридом галлия по параметрам решетки, хорошую теплопроводность для снятия тепловых ограничений и хорошие изолирующие свойства, обеспечивающие малые потери на высоких частотах [4]. Кроме того, они должны быть доступны и технологичны в обработке, а диаметр подложек должен быть достаточно большим, чтобы обеспечить экономически эффективное массовое производство. И, наконец, они должны быть достаточно дешевыми.
Сегодня наиболее полно этим требованиям отвечают подложки из Al2O3, SiC и Si. Однако, рассогласование по постоянной решетке Al2O3 подложки и GaN велико (14%). К тому же, теплопроводность Al2O3 подложек очень низкая (0,33 Вт/м*К), поэтому они в основном применяются при изготовлении маломощных приборов.
Список используемой литературы:
- А.А. Кищинский. Твердотельные СВЧ усилители мощности на нитриде галлия – состояние и перспективы развития. // Материалы 19 Крымской конференции “СВЧ техника и телекоммуникационные технологии”, Севастополь, 2009 г.
- Ю.Р. Ефименков, В.О. Ткаченко, В.Н. Данилин. Исследования по созданию мощного СВЧ транзистора с барьером Шоттки, на GaN, с затвором, сформированным с помощью электронной литографии. // Материалы V Международной научно-технической школы-конференции Молодые ученые – 2008, часть 1, стр. 148-151.
- В. Данилин, Т. Жукова, Ю. Кузнецов и др. Транзистор на GaN пока самый “крепкий орешек”. // Электроника: НТБ, 2005, №4, с.20-29.
- А. Васильев, В. Данилин, Т. Жукова. Новое поколение полупроводниковых материалов и приборов: через GaN к алмазу. // Электроника: Наука, Технология, Бизнес 2007, №4, с.68-76
- GaN and SiC. RF Power Transistor Selection Guide. // microsemi.com.
- 2729GN – 150. rev.1, Datasheet, July 2011 // microsemi.com.

Понравилась статья? Тогда поддержите нас, поделитесь с друзьями и заглядывайте по рекламным ссылкам!

